Optical characterization system by variable angle spectroscopic ellipsometer (WOOLLAM)
FACILITIES / OPTICAL-CHARACTERIZATION
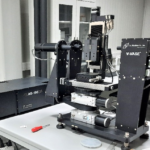
Optical characterization system by variable angle spectroscopic ellipsometer (WOOLLAM) – with wavelength range 200 – 1700 nm (6.2 – 0.73 eV), angle of incidence (35 – 90°), automated sample translation stage (for mapping) 150 mm × 150 mm, and an Instec temperature control stage (-160 – 600 °C).
VASE Woollam can be used in (a) reflection ellipsometry on semiconductor/dielectric thin films or multilayers (thicknesses, refractive index, extinction coefficient, absorption coefficient, dielectric function, band gap, critical point energies, electrical parameters for degenerate semiconductors – resistivity/conductivity, carrier density, scattering time, carrier mobility, phase transition in the temperature range -160 – 600 °C); and (b) transmission ellipsometry on uniaxial/biaxial crystals, glasses and glass ceramics (optical constants, linear birefringence and linear dichroism, Verdet constant/ Faraday rotation).
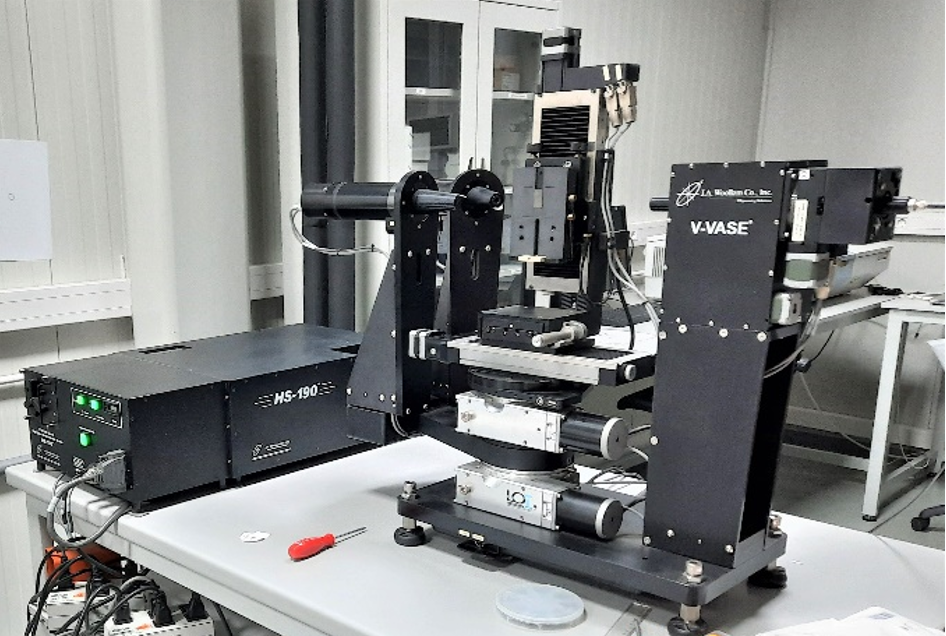
Copyright © 2025 National Institute of Materials Physics. All Rights Reserved